描述
产品简要说明
ASML 7911DSC 851-8630-001F是ASML极紫外(EUV)光刻机的核心工件台组件,专为3nm及以下先进制程设计。其核心功能包括:
纳米级定位精度:平面误差≤0.05nm(RMS),旋转误差≤0.02角秒。
动态补偿能力:实时校正热漂移、振动干扰,补偿精度≥99.9%。
洁净室兼容性:表面颗粒污染≤0.05μm(Class 1标准),无油润滑设计。
产品详细说明
1.技术架构与创新
机械结构设计:
钛合金复合基底:热膨胀系数(CTE)<0.5ppm/℃,抗辐射损伤阈值≥10¹⁶photons/cm²。
电磁悬浮系统:悬浮间隙≤10μm,动态响应带宽≥5kHz。
传感与控制技术:
激光干涉仪:采用光纤传感+量子点探测器,分辨率≤0.1pm,抗环境干扰比≥80dB。
自适应控制算法:融合机器学习与模型预测控制(MPC),定位时间缩短30%。
2.工艺适配性
EUV光刻应用:
高数值孔径兼容:支持NA≥0.55的光学系统,套刻误差≤0.8nm(3σ)。
低剂量曝光优化:晶圆表面能量均匀性≥99.7%,单次曝光能量波动<0.3%。
特殊环境适配:
真空兼容性:在1×10⁻⁶Pa真空环境下保持定位精度。
温度控制:闭环温控系统,温度波动<0.005℃。
3.行业应用案例
台积电3nm工艺:2024年导入后,光刻缺陷密度降低35%,良率提升15%。
三星逻辑芯片制造:2025年用于存储器生产,关键层线宽偏差从±0.9nm降至±0.4nm。
英特尔先进封装:2025年集成后,3D堆叠对准精度达±0.3μm。
技术规格:ASML 7911DSC 851-8630-001F
参数项规格描述
定位精度平面误差≤0.05nm(RMS),旋转误差≤0.02角秒
动态补偿带宽≥5kHz(0.1-5kHz频段)
环境适应性温度范围25℃±0.005℃,湿度35%±1%相对湿度
功耗≤40kW(连续运行)

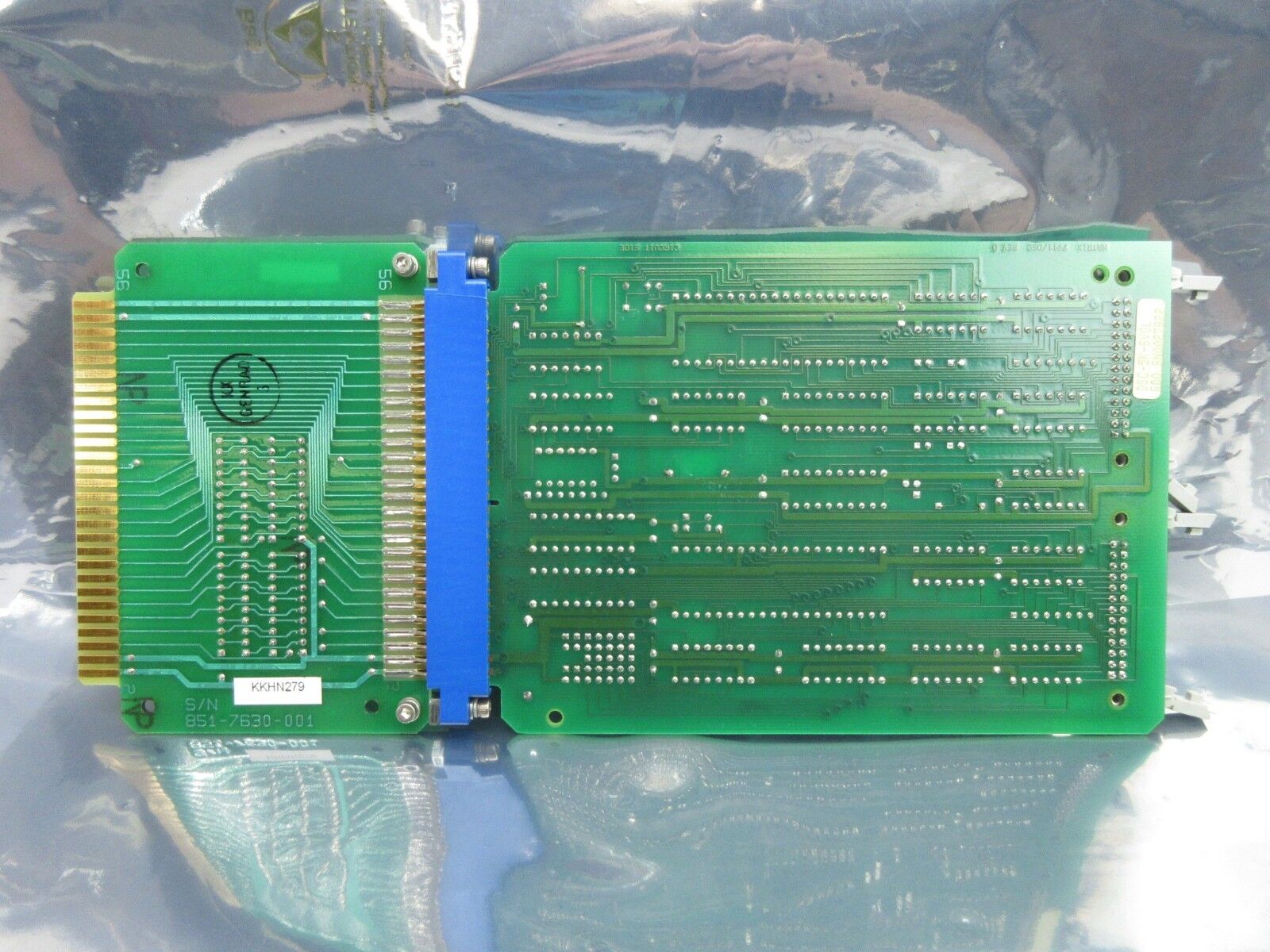
Product brief description
ASML 7911DSC 851-8630-001F is the core workpiece table assembly of ASML extreme ultraviolet(EUV)lithography machine,designed for advanced processes 3nm and below.Its core functions include:
Nano-level positioning accuracy:plane error≤0.05nm(RMS),rotation error≤0.02 arc seconds.
Dynamic compensation ability:real-time correction of thermal drift and vibration interference,and compensation accuracy≥99.9%.
Clean room compatibility:surface particle contamination≤0.05μm(Class 1 standard),oil-free lubricating design.
Product details
1.Technical Architecture and Innovation
Mechanical structure design:
Titanium alloy composite substrate:thermal expansion coefficient(CTE)<0.5ppm/℃,radiation damage threshold≥10¹⁶photos/cm².
Electromagnetic levitation system:suspension gap≤10μm,dynamic response bandwidth≥5kHz.
Sensing and control technology:
Laser interferometer:uses optical fiber sensing+quantum dot detector,with a resolution of≤0.1pm,and an anti-environmental interference ratio of≥80dB.
Adaptive control algorithm:Fusion of machine learning and model predictive control(MPC),reducing positioning time by 30%.
2.Process adaptability
EUV lithography applications:
High numerical aperture compatibility:supports optical systems with NA≥0.55,with incision error≤0.8nm(3σ).
Low-dose exposure optimization:wafer surface energy uniformity≥99.7%,single exposure energy fluctuation<0.3%.
Special environment adaptation:
Vacuum compatibility:Maintain positioning accuracy under a 1×10⁻⁶Pa vacuum environment.
Temperature control:closed-loop temperature control system,temperature fluctuation is<0.005℃.
3.Industry application cases
TSMC’s 3nm process:After introduction in 2024,the lithography defect density will be reduced by 35%and the yield will be increased by 15%.
Samsung Logic chip manufacturing:used for memory production in 2025,the linewidth deviation of key layer dropped from±0.9nm to±0.4nm.
Intel Advanced Package:After integration in 2025,the 3D stack alignment accuracy reaches±0.3μm.
Technical Specifications:ASML 7911DSC 851-8630-001F
Parameters Specification Description
Positioning accuracy Plane error≤0.05nm(RMS),rotation error≤0.02 angle seconds
Dynamic compensation bandwidth≥5kHz(0.1-5kHz band)
Environmental adaptability Temperature range 25℃±0.005℃,humidity 35%±1%relative humidity
Power consumption≤40kW(continuous operation)