描述
产品简要说明
ASML 851-8233-004是一款专为极紫外(EUV)光刻机设计的高精度运动控制模块,核心功能包括:
纳米级定位:X/Y轴重复定位精度≤0.8nm,Z轴≤1.2nm,θX/θY/θZ轴角定位精度≤80nrad。
动态响应:加速度≥12m/s²,闭环带宽≥1.2kHz。
抗环境干扰:通过ASML内部ISO 14130振动标准,可承受20Hz-2kHz频段6g振动。
产品详细说明
1.技术架构与创新
多轴协同控制:
解耦设计:采用磁悬浮+压电复合驱动,消除轴间耦合误差(<0.08%)。
实时补偿算法:基于机器学习的热形变预测模型,温度漂移补偿效率≥98%。
光学集成适配:
反射镜定位:支持EUV光学模块(如ZEPHYR反射镜组)的±40μm行程微调。
光路校准接口:集成干涉仪反馈通道(波长632.8nm),校准误差<0.03nm。
2.核心功能模块
动态负载平衡:
自适应阻尼:根据载荷质量(8-45kg)自动调节阻尼系数,振动抑制比≥45dB。
热管理:液冷循环系统(温度控制精度±0.05℃),避免热膨胀导致的定位漂移。
故障自检系统:
多传感器融合:集成加速度计、陀螺仪、位移传感器,实时监测6DOF运动状态。
故障隔离机制:单轴失效时,剩余轴可切换至安全模式,保持系统稳定性。
3.行业应用适配性
EUV光刻机集成:
晶圆台控制:驱动ASML TWINSCAN NXE:3600D光刻机的晶圆台(直径300mm),曝光场对准误差≤0.25nm。
光学掩模校准:配合PHILIPS X射线检测系统,实现掩模缺陷定位精度≤3nm。
量子计算设备:
超导量子比特阵列控制:支持4K低温环境下的纳米级位移(ΔZ≤0.3nm)。
磁屏蔽兼容:铁磁材料含量<0.0005%,避免对超导磁体产生干扰。
技术规格:ASML 851-8233-004
参数项规格描述
定位精度X/Y轴≤0.8nm,Z轴≤1.2nm,θX/θY/θZ轴≤80nrad
行程范围X/Y轴±40mm,Z轴±15mm,θX/θY/θZ轴±80μrad
工作温度-40℃至125℃(基础模式),-40℃至85℃(液冷模式)
功率消耗≤180W(连续运行)

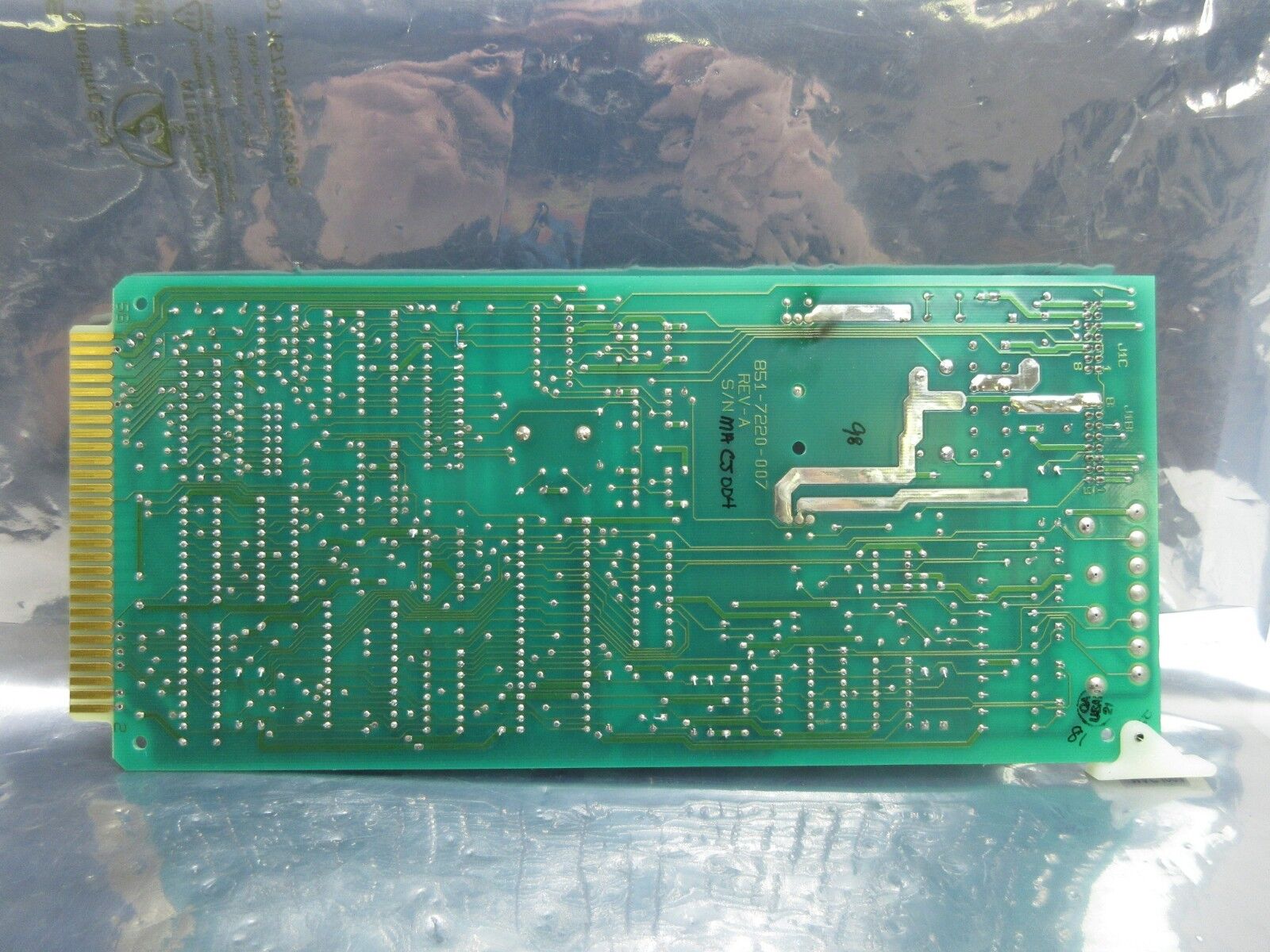
Product brief description
ASML 851-8233-004 is a high-precision motion control module designed for extreme ultraviolet(EUV)lithography machines,with core functions including:
Nano-level positioning:X/Y axis repeat positioning accuracy≤0.8nm,Z axis≤1.2nm,θX/θY/θZ axis angular positioning accuracy≤80nrad.
Dynamic response:acceleration≥12m/s²,closed-loop bandwidth≥1.2kHz.
Anti-environmental interference:Through the ASML internal ISO 14130 vibration standard,it can withstand 6g vibrations in the 20Hz-2kHz frequency band.
Product details
1.Technical Architecture and Innovation
Multi-axis collaborative control:
Decoupling design:Magnetic levitation+piezoelectric composite driving is used to eliminate the coupling error between the shafts(<0.08%).
Real-time compensation algorithm:a thermal deformation prediction model based on machine learning,with temperature drift compensation efficiency≥98%.
Optical Integration Adaptation:
Mirror positioning:Supports fine adjustment of±40μm stroke of EUV optical modules(such as ZEPHYR mirror group).
Optical path calibration interface:integrated interferometer feedback channel(wavelength 632.8nm),calibration error<0.03nm.
2.Core functional modules
Dynamic load balancing:
Adaptive damping:The damping coefficient is automatically adjusted according to the load mass(8-45kg),and the vibration suppression ratio is≥45dB.
Thermal management:liquid-cooled circulation system(temperature control accuracy±0.05℃)to avoid positioning drift caused by thermal expansion.
Fault self-test system:
Multi-sensor fusion:Integrated accelerometer,gyroscope,displacement sensor to monitor 6DOF motion status in real time.
Fault isolation mechanism:When a single axis fails,the remaining axis can be switched to safe mode to maintain system stability.
3.Industry application adaptability
EUV lithography machine integration:
Wafer control:drives the wafer table(diameter 300mm)of ASML TWINSCAN NXE:3600D lithography machine,and the exposure field alignment error is≤0.25nm.
Optical mask calibration:Combined with PHILIPS X-ray detection system,mask defect positioning accuracy is≤3nm.
Quantum computing devices:
Superconducting qubit array control:supports nanoscale displacement in 4K low temperature environment(ΔZ≤0.3nm).
Magnetic shielding compatibility:The ferromagnetic material content is<0.0005%,avoiding interference with superconducting magnets.
Technical Specifications:ASML 851-8233-004
Parameters Specification Description
Positioning accuracy X/Y axis≤0.8nm,Z axis≤1.2nm,θX/θY/θZ axis≤80nrad
Stroke range X/Y axis±40mm,Z axis±15mm,θX/θY/θZ axis±80μrad
Operating temperature-40℃to 125℃(basic mode),-40℃to 85℃(liquid cooling mode)
Power consumption≤180W(continuous operation)