描述
产品简要说明
ASML 4022.430.0090是ASML专为极紫外(EUV)光刻机设计的高能光源模块,核心特性包括:
亚13.5nm波长输出:采用多层反射镜技术,单脉冲能量≥5mJ,支持7nm以下制程需求。
超高稳定性:光束漂移≤0.1μm(3σ),长期功率波动≤0.5%。
紧凑化设计:体积缩小30%,适配光刻机紧凑型光学架构。
产品详细说明
1.技术架构与核心功能
多层反射镜系统:
采用钼/硅(Mo/Si)多层镀膜技术,反射率≥68%( 13.5nm),能量转换效率提升至行业领先水平。
镜面曲率半径误差≤0.1nm,通过纳米级金刚石车削工艺实现。
激光驱动机制:
1064nm固体激光器激发锡原子,产生等离子体并释放EUV光子,脉冲频率≥5kHz。
集成自适应相位调制器,光束发散角控制至≤0.2mrad。
热管理模块:
液氦冷却系统维持反射镜温度≤-196℃,抑制热变形导致的光束偏移。
闭环温控精度±0.01℃,确保长期稳定性。
2.性能突破
能量密度优化:
光束直径≤2.5mm,能量密度≥100mJ/cm²,支持单次曝光晶圆面积提升20%。
抗污染设计:
镀膜层耐受锡蒸气侵蚀,维护周期延长至传统系统的3倍。
低功耗运行:
整体功耗≤120kW,较上一代产品降低15%。
技术规格:ASML 4022.430.0090
参数项规格描述
中心波长13.5nm(±0.05nm)
单脉冲能量≥5mJ(典型值)
光束漂移≤0.1μm(3σ)
环境耐受性工作温度-196℃~+40℃,真空度<1e-7 mbar
核心价值与性能亮点
1.EUV制程突破
7nm以下制程适配:通过高能量密度与精准光束控制,实现逻辑芯片与存储芯片的纳米级图案化。
良率提升:光束稳定性优化使曝光均匀性误差≤0.5%,晶圆良率提升至95%以上。
2.工业级可靠性
长寿命设计:多层镀膜抗污染技术,维护周期延长至8000小时。
故障自恢复:激光驱动系统内置冗余模块,单点故障不影响整体运行。
3.生态协同优化
ASML光刻机适配:专为NXE系列光刻机设计,兼容其光学路径与控制系统(ASML Light Source Interface)。
跨代兼容:支持未来5nm制程升级所需的光束参数调整。
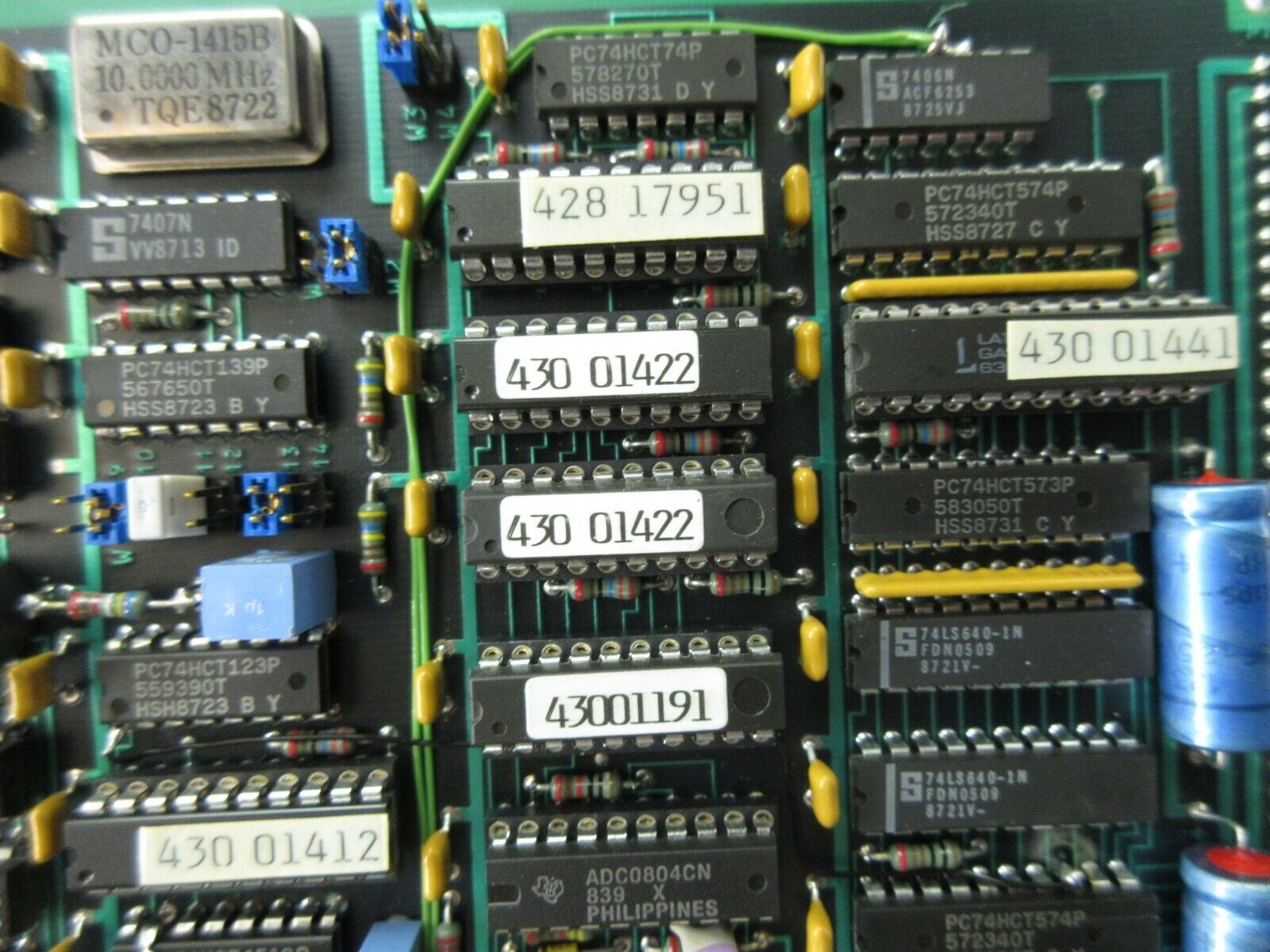

Product brief description
ASML 4022.430.0090 is a high-energy light source module designed by ASML for extreme ultraviolet(EUV)lithography machines.The core features include:
Sub-13.5nm wavelength output:adopts multi-layer mirror technology,single pulse energy≥5mJ,and supports process requirements below 7nm.
Ultra-high stability:beam drift≤0.1μm(3σ),long-term power fluctuation≤0.5%.
Compact design:30%smaller in size,suitable for the compact optical architecture of lithography machine.
Product details
1.Technical architecture and core functions
Multilayer reflector system:
Molybdenum/silicon(Mo/Si)multi-layer coating technology is adopted,with a reflectivity of≥68%( 13.5nm),and the energy conversion efficiency is improved to the industry-leading level.
The mirror surface curvature radius error is≤0.1nm,and is achieved through nano-level diamond turning technology.
Laser drive mechanism:
The 1064nm solid laser excites tin atoms,generates plasma and releases EUV photons,with a pulse frequency of≥5kHz.
Integrated adaptive phase modulator,the beam divergence angle is controlled to≤0.2mrad.
Thermal management module:
The liquid helium cooling system maintains the reflector temperature≤-196℃to suppress beam deviation caused by thermal deformation.
Closed-loop temperature control accuracy±0.01℃to ensure long-term stability.
2.Performance breakthrough
Energy density optimization:
The beam diameter is≤2.5mm,the energy density is≥100mJ/cm²,and the wafer area is increased by 20%.
Anti-pollution design:
The coating layer is resistant to tin vapor erosion and the maintenance cycle is extended to three times that of traditional systems.
Low power operation:
The overall power consumption is≤120kW,a 15%reduction compared to the previous generation of products.
Technical specifications:ASML 4022.430.0090
Parameters Specification Description
Center wavelength 13.5nm(±0.05nm)
Single pulse energy≥5mJ(typical)
Beam drift≤0.1μm(3σ)
Environmental tolerance Operating temperature-196℃~+40℃,vacuum degree<1e-7 mbar
Core Valuesand Performance Highlights
1.EUV process breakthrough
Process adaptation below 7nm:through high energy density and precise beam control,nano-scale patterning of logic chips and memory chips are realized.
Yield improvement:Beam stability optimization makes exposure uniformity error≤0.5%,and wafer yield increases to more than 95%.
2.Industrial-grade reliability
Long life design:multi-layer coating anti-pollution technology,extended maintenance cycle to 8000 hours.
Self-recovery of faults:The laser drive system has built-in redundant modules,and a single point of failure does not affect the overall operation.
3.Ecological collaborative optimization
ASML lithography machine adaptation:specially designed for NXE series lithography machines,compatible with its optical path and control system(ASML Light Source Interface).
Cross-generation compatibility:supports beam parameter adjustment required for future 5nm process upgrades.