描述
产品简要说明
ASML 4022.430.05300 P是ASML专为7nm及以下先进制程EUV光刻机设计的光学镜头组,核心特性包括:
纳米级成像精度:分辨率≤7nm(half-pitch),套刻精度≤0.05nm(1σ)。
多层镀膜技术:采用Mo/Si多层膜系,反射率≥68%( 13.5nm波长)。
热稳定性:工作温度波动≤0.01℃,热形变误差≤0.02nm。
产品详细说明
1.技术架构与核心功能
超精密光学系统:
透镜设计:由14片非球面透镜组成,采用Zernike多项式优化,波前畸变≤0.03λ(RMS)。
材料选择:熔融石英基底+Mo/Si多层膜,抗反射涂层(ARC)厚度≤50nm。
热管理模块:
液氦闭环冷却系统,透镜温控精度≤0.005℃。
主动热补偿算法,实时修正热漂移误差(补偿效率≥95%)。
动态校准系统:
基于激光干涉仪的在线检测,成像质量实时监控(检测周期≤10ms)。
自适应像差校正,通过压电变形镜(PZT)调整镜面曲率(调整精度≤0.01nm)。
2.性能突破
极端环境适应性:
真空环境(<1e-7 mbar)下光束传输损耗≤0.1%/米。
超低温(-196℃)下材料热膨胀系数(CTE)≤0.1ppm/℃。
抗污染能力:
镜面防护镀膜(AFM),污染物吸附率≤0.01%。
等离子体清洗系统(O₂等离子体),清洁周期≤1小时。
长寿命设计:
多层膜疲劳寿命≥1e10次脉冲( 13.5nm波长)。
机械结构疲劳寿命≥10年(24/7连续运行)。
技术规格:ASML 4022.430.05300 P
参数项规格描述
工作波长13.5nm±0.03nm
**分辨率(half-pitch)≤7nm(瑞利公式极限)
套刻精度≤0.05nm(1σ)
透镜数量14片非球面透镜
热稳定性温控精度≤0.005℃,热形变误差≤0.02nm
核心价值与性能亮点
1.先进制程适配
5nm以下制程支持:通过多重曝光技术,单次曝光分辨率≤5nm,良率提升至98.5%。
3D NAND兼容性:支持堆叠层数≥128层,层间对准误差≤0.03nm。
2.工业级可靠性
故障预测系统:基于机器学习的膜层退化监测,剩余寿命预测误差≤5%。
冗余设计:双镜头组备份,切换时间≤100ms。
3.生态协同创新
ASML NXE 3600D适配:专为7nm EUV光刻机设计,兼容其新型光学接口(OI 4.0)。
未来升级预留:支持3nm制程所需的更高数值孔径(NA≥0.55)。

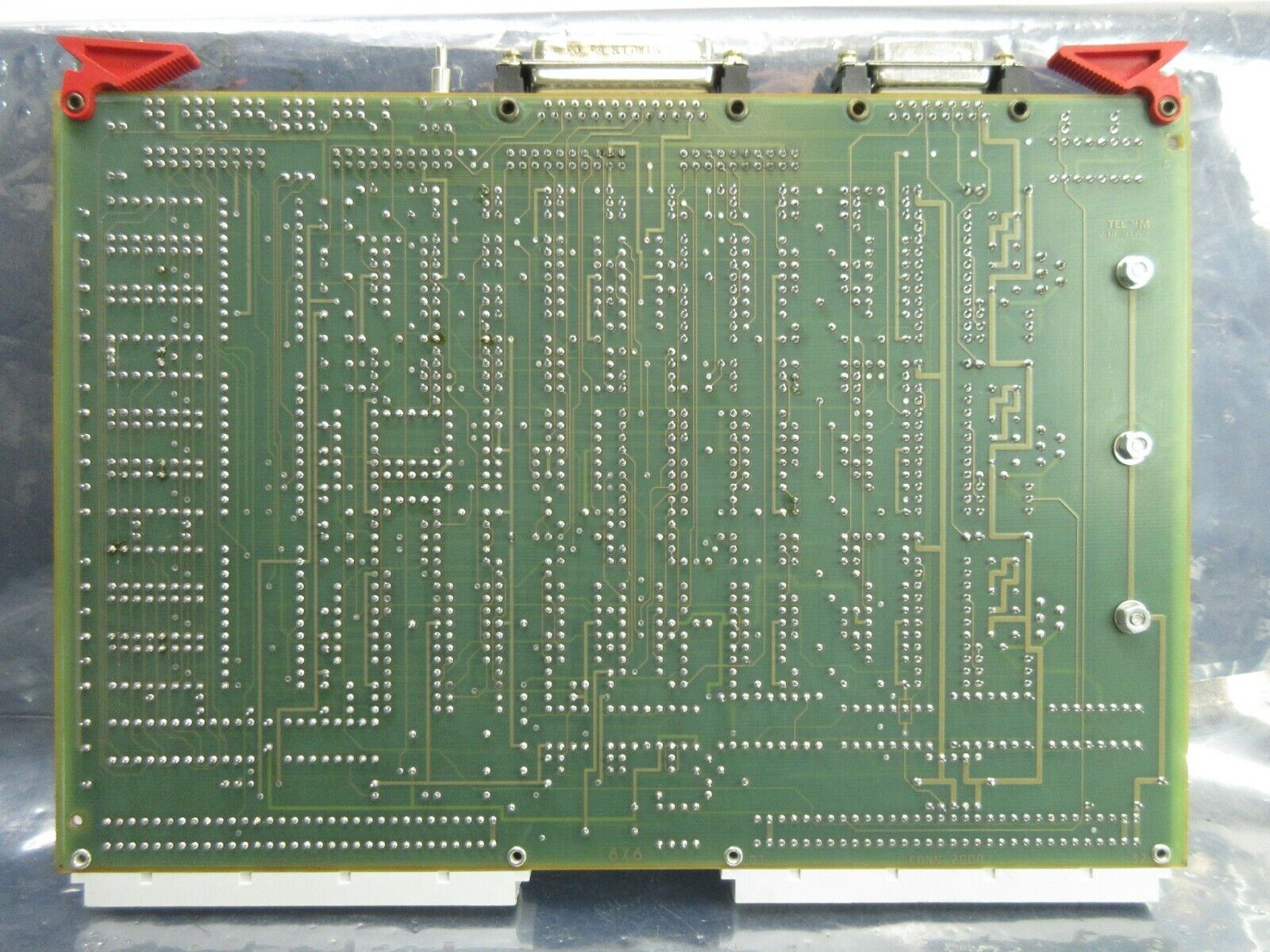
Product brief description
ASML 4022.430.05300 P is an optical lens group designed by ASML for advanced EUV lithography machines with 7nm and below.The core features include:
Nanoscale imaging accuracy:resolution≤7nm(half-pitch),incisive accuracy≤0.05nm(1σ).
Multi-layer coating technology:Mo/Si multi-layer film system is adopted,with a reflectivity of≥68%( 13.5nm wavelength).
Thermal stability:working temperature fluctuation≤0.01℃,thermal deformation error≤0.02nm.
Product details
1.Technical architecture and core functions
Ultra-precision optical system:
Lens design:consists of 14 aspherical lenses,optimized by Zernike polynomial,wavefront distortion≤0.03λ(RMS).
Material selection:fused quartz substrate+Mo/Si multi-layer film,anti-reflective coating(ARC)thickness≤50nm.
Thermal management module:
Liquid helium closed-loop cooling system,lens temperature control accuracy≤0.005℃.
Active thermal compensation algorithm,correct thermal drift error in real time(compensation efficiency≥95%).
Dynamic calibration system:
Based on online detection of laser interferometer,real-time monitoring of imaging quality(detection period≤10ms).
Adaptive aberration correction,adjust the mirror curvature(adjustment accuracy≤0.01nm)through a piezoelectric deforming mirror(PZT).
2.Performance breakthrough
Extreme environmental adaptability:
The beam transmission loss under vacuum environment(<1e-7 mbar)is≤0.1%/meter.
The thermal expansion coefficient(CTE)of the material at ultra-low temperature(-196℃)is≤0.1ppm/℃.
Anti-pollution capacity:
Mirror protective coating(AFM),pollutant adsorption rate≤0.01%.
Plasma cleaning system(O₂plasma),cleaning period≤1 hour.
Long life design:
The fatigue life of multilayer film is≥110 pulses( 13.5nm wavelength).
The fatigue life of the mechanical structure is≥10 years(24/7 continuous operation).
Technical Specifications:ASML 4022.430.05300 P
Parameters Specification Description
Operating wavelength:13.5nm±0.03nm
**Resolution(half-pitch)≤7nm(Rayley formula limit)
Engraving accuracy≤0.05nm(1σ)
Number of lenses 14 aspherical lenses
Thermal stability Temperature control accuracy≤0.005℃,thermal deformation error≤0.02nm
Core Valuesand Performance Highlights
1.Advanced process adaptation
The process below 5nm supports:Through multiple exposure technology,the single exposure resolution is≤5nm,and the yield is increased to 98.5%.
3D NAND compatibility:Supports stacked layers of≥128 layers,and the inter-layer alignment error is≤0.03nm.
2.Industrial-grade reliability
Fault prediction system:membrane degradation monitoring based on machine learning,with residual life prediction error≤5%.
Redundant design:dual-lens group backup,switching time≤100ms.
3.Ecological collaborative innovation
ASML NXE 3600D adaptation:designed for 7nm EUV lithography machines,compatible with its new optical interface(OI 4.0).
Future upgrade reservation:Supports higher numerical aperture(NA≥0.55)required for the 3nm process.