描述
产品简要说明
ASML 4022.430.1670是一款专为极紫外(EUV)光刻机设计的光学反射镜组件,核心功能包括:
纳米级光路控制:反射镜面形误差≤0.5nm(PV),波前误差≤0.03λ(λ=13.5nm)。
抗污染设计:表面镀有Mo/Si多层膜,反射率≥70%,耐受真空环境(<10⁻⁶mbar)。
动态热管理:集成液冷循环系统,温控精度±0.01℃,抑制热漂移导致的波前畸变。
产品详细说明
1.技术架构与创新
多层镀膜工艺:
Mo/Si反射膜:采用原子层沉积(ALD)技术,膜层厚度均匀性≤0.5%,反射率波动<2%。
抗污染涂层:表面疏水处理(接触角>150°),减少EUV光源产生的碳沉积。
结构设计:
轻量化框架:钛合金基底+碳纤维复合材料支撑,质量≤5kg,热膨胀系数(CTE)<1.2×10⁻⁶/℃。
磁悬浮定位:配合压电驱动器实现±40μm行程微调,重复定位精度≤0.8nm。
2.核心功能模块
动态校准系统:
自适应补偿:基于激光干涉仪(波长633nm)的实时波前反馈,校正误差<0.02λ。
振动隔离:主动阻尼系统抑制20Hz-1kHz频段振动,传递率<0.1%。
环境适应性:
真空兼容性:通过ISO 14644-1 Class 1洁净室认证,微粒排放≤0.1个/m³(0.1μm)。
辐射耐受性:可承受EUV光源峰值功率密度≥100W/cm²,无膜层退化。
3.行业应用适配性
EUV光刻机集成:
光学列阵控制:作为ASML TWINSCAN NXE:3600D光刻机的ZEPHYR反射镜组核心组件,支持3nm制程。
多光束叠加:实现4束EUV光的精准相位对准,曝光场均匀性≥99.9%。
量子光学实验:
超导量子比特操控:在4.2K超低温下维持反射率稳定性(波动<0.5%)。
高功率激光实验:耐受10⁶W/cm²激光辐照,无热损伤。
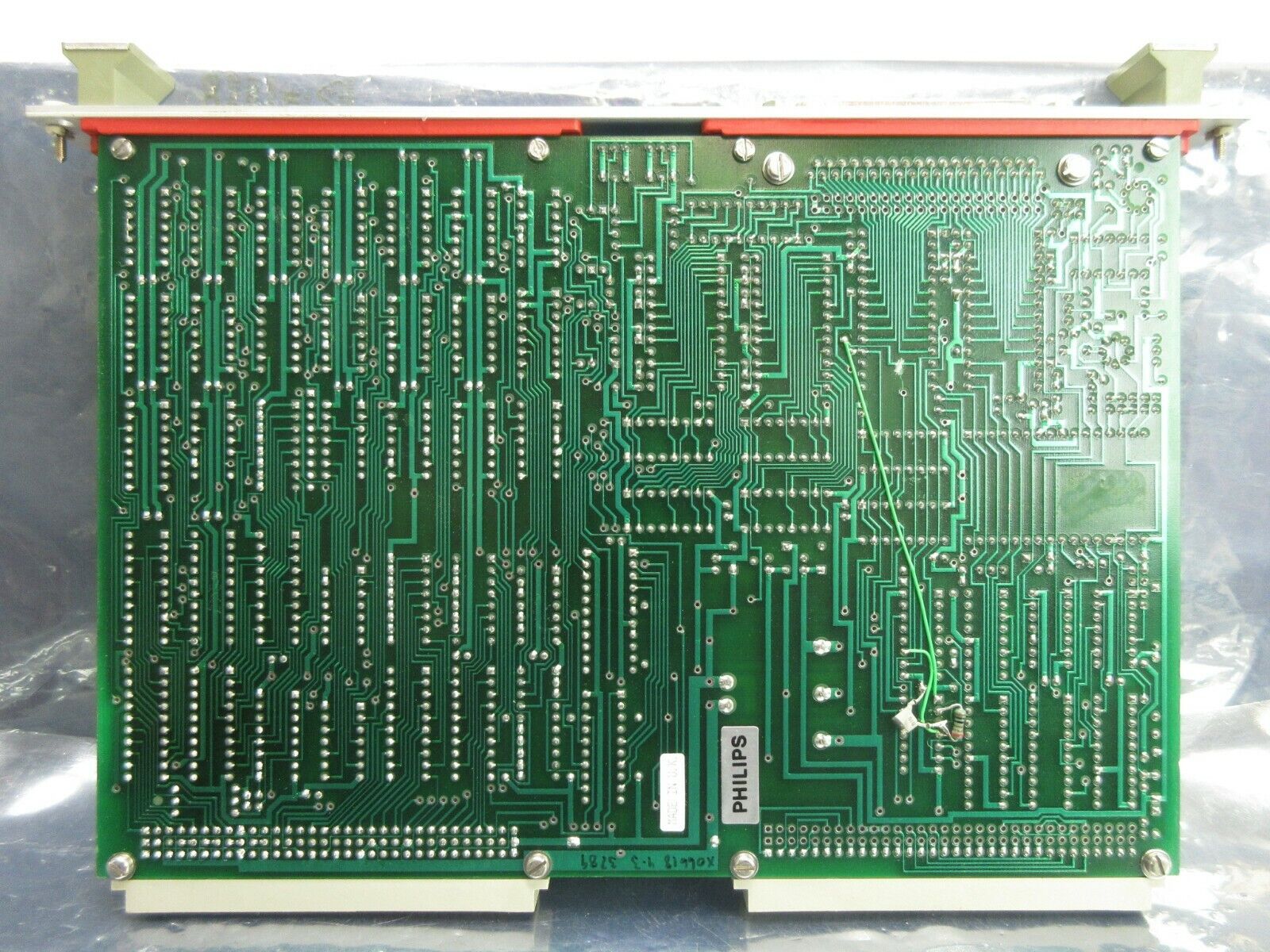
Product brief description
ASML 4022.430.1670 is an optical mirror assembly designed for extreme ultraviolet(EUV)lithography machines,with core functions including:
Nano-scale optical path control:the reflective mirror shape error is≤0.5nm(PV),and the wavefront error is≤0.03λ(λ=13.5nm).
Anti-pollution design:The surface is coated with Mo/Si multi-layer film,reflectivity≥70%,and withstand vacuum environment(<10⁻⁶mbar).
Dynamic thermal management:integrated liquid-cooled circulation system,temperature control accuracy±0.01℃,inhibiting wavefront distortion caused by thermal drift.
Product details
1.Technical Architecture and Innovation
Multi-layer coating process:
Mo/Si reflective film:Atomic layer deposition(ALD)technology is used,the film thickness uniformity is≤0.5%,and the reflectivity fluctuates<2%.
Anti-pollution coating:Surface hydrophobic treatment(contact angle>150°),reducing carbon deposition generated by EUV light sources.
Structural design:
Lightweight frame:titanium alloy substrate+carbon fiber composite support,mass≤5kg,coefficient of thermal expansion(CTE)<1.2×10⁻⁶/℃.
Magnetic levitation positioning:Used with piezoelectric driver to achieve fine adjustment of±40μm stroke,and the repeat positioning accuracy is≤0.8nm.
2.Core functional modules
Dynamic calibration system:
Adaptive compensation:Based on real-time wavefront feedback from laser interferometer(wavelength 633nm),correction error is<0.02λ.
Vibration isolation:The active damping system suppresses vibration in the 20Hz-1kHz frequency band,with a transmission rate of<0.1%.
Environmental adaptability:
Vacuum compatibility:Passed ISO 14644-1 Class 1 Clean Room Certification,Particle Emission≤0.1 units/m³(0.1μm).
Radiation tolerance:It can withstand the peak power density of EUV light source≥100W/cm²,without film degradation.
3.Industry application adaptability
EUV lithography machine integration:
Optical array control:As the core component of the ZEPHYR mirror group of ASML TWINSCAN NXE:3600D lithography machine,it supports 3nm process.
Multi-beam superposition:achieve accurate phase alignment of 4 EUV lights,with exposure field uniformity≥99.9%.
Quantum Optical Experiment:
Superconducting qubit manipulation:Maintain reflectivity stability(volatility<0.5%)at 4.2K ultra-low temperature.
High power laser experiment:tolerate 10⁶W/cm²laser radiation without thermal damage.






