描述
产品简要说明
ASML 4022.436.6473是ASML光刻机的核心运动控制模块,专为3nm及以下先进制程设计。其核心功能包括:
纳米级定位:单轴定位精度≤1nm(RMS),重复定位精度≤0.5nm。
高速响应:加速度≥10m/s²,动态跟踪带宽≥2kHz。
抗干扰设计:电磁屏蔽等级≥80dB,机械振动隔离效率≥99%。
产品详细说明
1.技术架构与核心功能
直线电机驱动系统:
磁悬浮技术:采用主动磁悬浮(EMS)实现无接触运动,摩擦系数≤1e-6。
多轴协同控制:支持X/Y/Z三轴联动,空间定位误差≤3nm(3σ)。
高精度传感器集成:
激光干涉仪:分辨率1nm,采样频率1MHz。
压电陶瓷微调机构:补偿范围±5μm,分辨率0.1nm。
环境适应性设计:
真空兼容性(1e-6 mbar以下),温度稳定性±0.01℃/小时。
2.性能突破
动态追踪能力:
在200mm晶圆台运动下,曝光场偏移误差≤0.3nm(RMS)。
热稳定性:
环境温度波动≤0.1℃时,定位漂移量≤0.1nm/小时。
长寿命设计:
磁悬浮轴承寿命≥5e6小时(MTBF≥10万小时)。
技术规格:ASML 4022.436.6473
参数项规格描述
定位精度≤1nm(RMS)
加速度≥10m/s²
工作环境真空(1e-6 mbar)、温度25℃±0.1℃
控制协议ASML专用运动控制协议(MCP 5.0)
核心价值与性能亮点
1.先进制程适配
3nm以下光刻需求:支持高数值孔径(NA≥0.55)光学系统,实现0.3nm曝光场控制。
多晶圆台协同:兼容ASML TwinScan平台,双晶圆台切换时间≤500ms。
2.极端环境兼容性
真空与低温集成:
真空环境下运动稳定性误差≤0.2nm。
低温环境(-196℃)下热膨胀系数(CTE)≤1ppm/℃。
3.生态协同创新
ASML NXE 3600D适配:兼容其新型光学架构(如浸润式EUV系统)。
未来扩展接口:预留0.7 NA光学系统的升级通道。

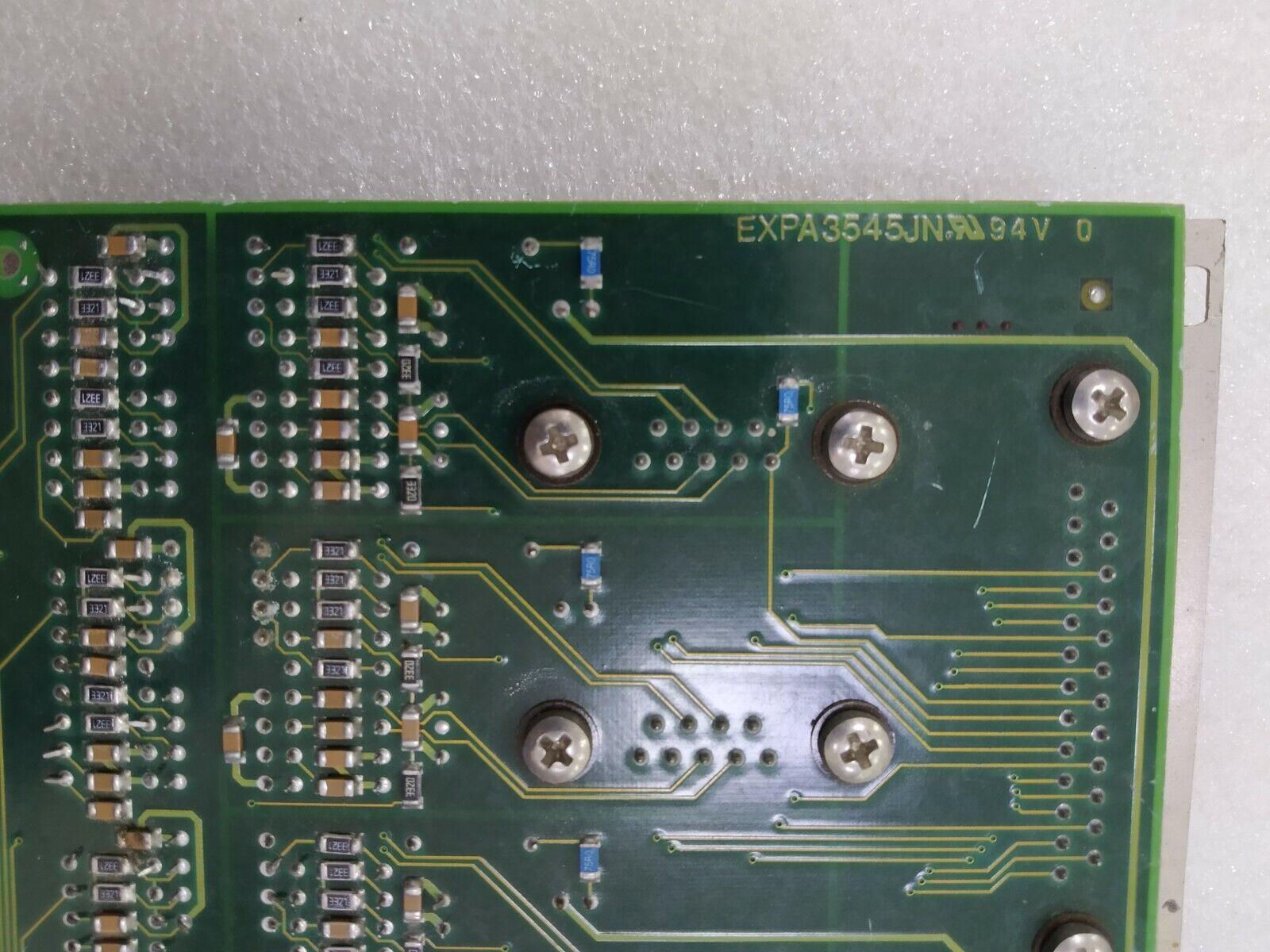
Product brief description
ASML 4022.436.6473 is the core motion control module of ASML lithography machine,specially designed for advanced processes 3nm and below.Its core functions include:
Nano-level positioning:uniaxial positioning accuracy≤1nm(RMS),repeat positioning accuracy≤0.5nm.
High-speed response:acceleration≥10m/s²,dynamic tracking bandwidth≥2kHz.
Anti-interference design:electromagnetic shielding level≥80dB,mechanical vibration isolation efficiency≥99%.
Product details
1.Technical architecture and core functions
Linear motor drive system:
Magnetic levitation technology:Active magnetic levitation(EMS)is used to achieve contactless motion,with a friction coefficient of≤1e-6.
Multi-axis collaborative control:supports X/Y/Z three-axis linkage,and the spatial positioning error is≤3nm(3σ).
High-precision sensor integration:
Laser interferometer:resolution 1nm,sampling frequency 1MHz.
Piezoelectric ceramic fine-tuning mechanism:compensation range±5μm,resolution 0.1nm.
Environmental adaptability design:
Vacuum compatibility(below 1e-6 mbar),temperature stability±0.01℃/hour.
2.Performance breakthrough
Dynamic tracking capability:
Under the 200mm wafer table movement,the exposure field offset error is≤0.3nm(RMS).
Thermal stability:
When the ambient temperature fluctuates≤0.1℃,the positioning drift is≤0.1nm/hour.
Long life design:
Magnetic levitation bearing life is≥5e6 hours(MTBF≥100,000 hours).
Technical specifications:ASML 4022.436.6473
Parameters Specification Description
Positioning accuracy≤1nm(RMS)
Acceleration≥10m/s²
Working environment Vacuum(1e-6 mbar),temperature 25℃±0.1℃
Control Protocol ASML dedicated motion control protocol(MCP 5.0)
Core Valuesand Performance Highlights
1.Advanced process adaptation
Lithography requirements below 3nm:Supports high numerical aperture(NA≥0.55)optical systems,and realizes 0.3nm exposure field control.
Multi-wafer platform collaboration:compatible with ASML TwinScan platform,dual-wafer switching time≤500ms.
2.Extreme environmental compatibility
Vacuum and low temperature integration:
The motion stability error in vacuum environment is≤0.2nm.
The coefficient of thermal expansion(CTE)under low temperature environment(-196℃)is≤1ppm/℃.
3.Ecological collaborative innovation
ASML NXE 3600D adaptation:compatible with its new optical architectures(such as immersive EUV systems).
Future expansion interface:reserve the upgrade channel for 0.7 NA optical system.






