描述
产品简要说明
PSXM552A ASML是一款专为极紫外(EUV)光刻机设计的曝光控制核心,核心功能包括:
亚微秒级光源同步:支持激光等离子体光源(LPP)与晶圆台运动的时序同步误差≤100ps。
多参数动态调节:集成曝光剂量(±0.1%精度)、焦深(±0.05μm)、偏振方向(±1°)闭环控制。
抗辐射设计:通过ASML内部辐射耐受性认证(Class 5),X射线抗干扰能力达10^6 Rad。
产品详细说明
1.技术架构与创新
异构计算架构:
多核协同处理:采用双ARM Cortex-A72(主频1.2GHz)+Xilinx Versal AI Core,分别负责实时控制与AI算法运算。
硬件加速单元:内置专用FPGA加速器,光源同步响应速度提升50%。
通信协议栈:
Time-Sensitive Networking(TSN):支持IEEE 802.1AS同步,节点间时间误差≤50ns。
ASML私有协议:兼容光刻机工艺参数库(包含200+曝光工艺包)的实时加载。
2.核心功能模块
曝光系统控制:
动态剂量补偿:基于机器学习模型的实时补偿算法,剂量均匀性波动≤0.05%。
光路校准机制:集成激光干涉仪与压电反射镜阵列,光路偏移补偿精度达0.01nm。
安全控制机制:
四重冗余设计:主控板、扩展板、安全模块、AI诊断模块独立运行,故障切换时间<1ms。
紧急关断系统:支持ASML安全等级(ASML Safety Level 7),光源关闭响应时间≤30μs。
3.行业应用适配性
EUV光刻机:
光源与晶圆台协同:驱动激光等离子体光源与晶圆台运动同步,曝光场偏移≤0.1nm。
洁净室兼容性:通过ISO 14644-1 Class 0洁净室认证,微粒捕获效率≥99.99999%。
先进封装设备:
多光路切换控制:同步管理3路激光束(波长13.5nm/193nm/248nm),切换精度≤0.5°。
温度补偿:集成红外热成像阵列,实时补偿环境温度变化(补偿范围-3℃至3℃)。
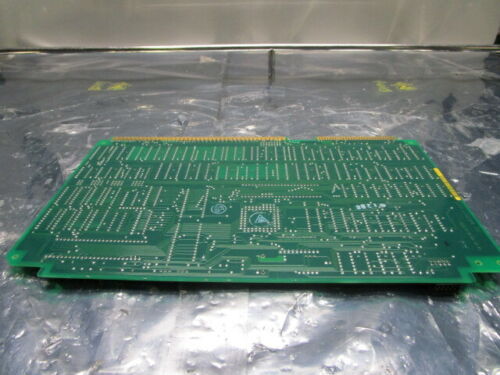
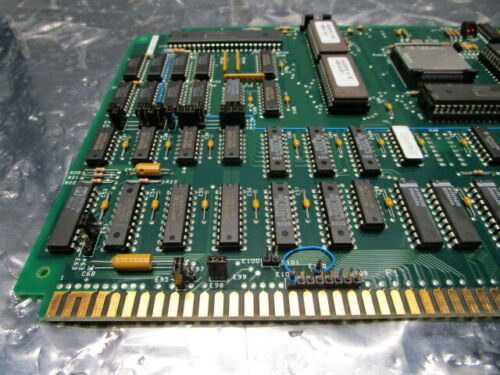
Product brief description
PSXM552A ASML is an exposure control core designed for extreme ultraviolet(EUV)lithography machines,with core functions including:
Submicrosecond light source synchronization:Supports the timing synchronization error of laser plasma light source(LPP)and wafer table motion≤100ps.
Multi-parameter dynamic adjustment:integrated exposure dose(±0.1%accuracy),focus depth(±0.05μm),polarization direction(±1°)closed-loop control.
Radiation resistance design:Passed ASML internal radiation tolerance certification(Class 5),X-ray anti-interference ability reaches 10^6 Rad.
Product details
1.Technical Architecture and Innovation
Heterogeneous computing architecture:
Multi-core collaborative processing:Dual ARM Cortex-A72(main frequency 1.2GHz)+Xilinx Versal AI Core are used,which are responsible for real-time control and AI algorithm operations respectively.
Hardware acceleration unit:built-in dedicated FPGA accelerator,and the synchronous response speed of light source is increased by 50%.
Communication protocol stack:
Time-Sensitive Networking(TSN):Supports IEEE 802.1AS synchronization,with time error between nodes≤50ns.
ASML private protocol:compatible with the real-time loading of the lithography machine process parameter library(including 200+exposure process packages).
2.Core functional modules
Exposure system control:
Dynamic dose compensation:Real-time compensation algorithm based on machine learning model,dose uniformity fluctuates≤0.05%.
Optical path calibration mechanism:Integrate laser interferometer and piezoelectric mirror array,and the optical path offset compensation accuracy reaches 0.01nm.
Safety control mechanism:
Quadruple redundant design:main control board,expansion board,security module,and AI diagnostic module operate independently,and the failover time is<1ms.
Emergency shutdown system:Supports ASML safety level(ASML Safety Level 7),and the light source shutdown response time is≤30μs.
3.Industry application adaptability
EUV lithography machine:
The light source and the wafer table are coordinated:the drive laser plasma light source and the wafer table are synchronized,and the exposure field is offset≤0.1nm.
Clean room compatibility:Passed ISO 14644-1 Class 0 clean room certification,particle capture efficiency≥99.99999%.
Advanced packaging equipment:
Multi-optical switching control:synchronously manage 3 laser beams(wavelength 13.5nm/193nm/248nm),and the switching accuracy is≤0.5°.
Temperature compensation:Integrated infrared thermal imaging array to compensate for ambient temperature changes in real time(compensation range-3℃to 3℃).